半导体与电路板是台湾经济成长的二个重要命脉,工研院研发「高深宽比玻璃基板电镀填孔及检测技术」,能确保电讯与电力的传输品质,让半导体先进封装技术,由硅晶圆级封装升级为玻璃面板级封装,协助半导体与电路板产业快速切入下世代生产制造。
工研院机械所副组长黄萌祺指出,玻璃中介层先进封装技术,可透过3D堆迭技术整合晶片与印刷电路板,取代现有的IC载板,一直是全球大厂关注的平台技术。
随着半导体先进制程不断演进,使镶嵌在中介层中立体导线的深宽比不断增加,深宽比愈高也代表制程愈难,因此半导体产业封装能否升级,关键就在研发出可确保电讯和电力传输无碍的高深宽比电镀填孔技术。
工研院以全湿式制程研发的「高深宽比玻璃基板电镀填孔及检测技术」,具有高深宽比、高品质及低成本的「二高一低」特色。
高深宽比达15是全球最佳,领先产学界的4到10,採用玻璃基板电镀填孔,能有效降低电镀制程缺陷,达到无缺陷填孔的目标,确保产品高品质,也解决目前先进封装堆迭整合问题。
更重要的是,採用全湿式制程可提升7成阶梯覆盖率,使成本降低5成,搭配超高解析3D X光检测技术,能精准确保产品的良率。
黄萌祺形容这项技术就像盖大楼,玻璃基板有如楼地板,必须将楼板钻孔打通,串接上下层管线,大楼才能顺畅运作,大楼盖得再高,也能保证电讯与电力的传输品质,协助业界解决痛点。
该技术今年获得工研菁英杰出研究金牌奖,目前已与国际玻璃大厂合作,协助半导体先进封装技术,由硅晶圆级封装升级为玻璃面板级封装,切入国际半导体封装、显示器与PCB供应链,协助台湾产业与国际市场无缝接轨。
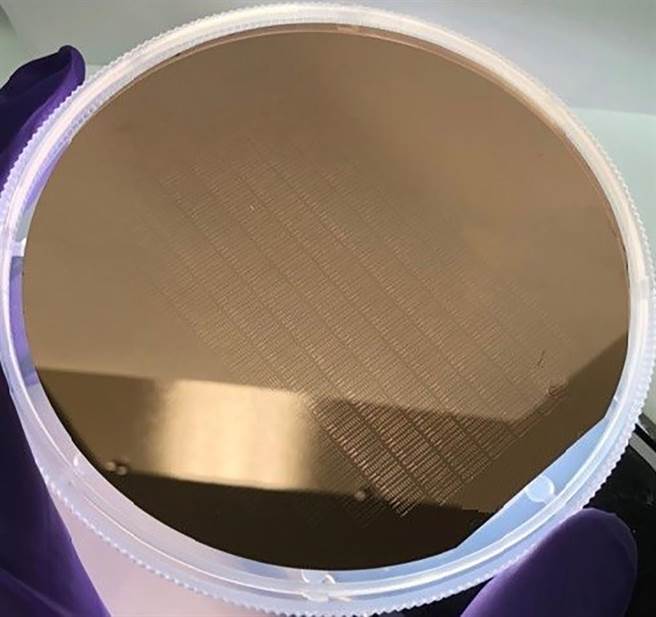
发表意见
中时新闻网对留言系统使用者发布的文字、图片或檔案保有片面修改或移除的权利。当使用者使用本网站留言服务时,表示已详细阅读并完全了解,且同意配合下述规定:
违反上述规定者,中时新闻网有权删除留言,或者直接封锁帐号!请使用者在发言前,务必先阅读留言板规则,谢谢配合。